RF设备的材料创新只有一种方法?
电脑杂谈 发布时间:2020-06-30 19:25:24 来源:网络整理
当您看到此标题并单击进入本文时,我相信您已经对这个问题有了答案.
在射频设备中只有一种方法可以进行材料创新吗?
当然不是. 现在暂时不用考虑问题,但是当任何事情被认为是唯一的解决方法时,这一点值得怀疑和讨论.
因此,关于射频设备的未来创新,我们不妨进行讨论.
RF设备概述
射频设备是无线连接的核心,是实现信号发送和接收的基本部分,具有广泛的应用范围. 射频设备包括射频开关和LNA,射频PA,滤波器,天线调谐器和毫米波FEM等. 其中,滤波器约占射频设备市场价值的50%,射频PA约占30%. %,RF开关和LNA约占10%. 其他约占10%. 可以看出,滤波器和功率放大器是射频设备的重要组成部分. PA负责传输通道的信号放大,滤波器负责过滤发射机接收的信号.
目前,射频设备的主要市场如下: 手机和通信模块市场,约占80%; WIFI路由器市场约占9%;通信基站市场,约占9%; NB-IoT市场约占2%.
随着5G技术的成熟,商业化趋势正在加速. 5G需要支持新的频段和通信标准. 作为无线连接的核心,诸如RF前端的滤波器,功率放大器,开关,天线和调谐器之类的核心设备已成为当前市场的焦点.
分析师预测,到2023年,射频前端市场规模将超过352亿美元,复合年增长率为14%. 快速增长的市场使该行业看到了机会. 新的射频公司不断涌现. 国频制造商已成为独立的射频供应链. 许多制造商都追求这种情况. 但是,从现状来看,差距仍然很明显.

纵观国内市场,在当地射频制造商的共同努力下,2G射频设备的更换率高达95%,3G的更换率达到85%,4G的更换率仅为15% ,而5G RF领域的替换率基本上为零.
国频设备制造商大致如下:
过滤器制造商
4G PA的主要制造商
国内主要3G PA制造商
国内主要2G PA制造商:
国内主要的WIFI PA / FEM制造商:
主要的国内开关制造商:
此外,RF设备的制造,包装和测试可以由国内制造商完成. 从设计到晶圆代工,再到封装测试,国频芯片产业链已基本成熟,已形成完整的产业链. 然而,就国际竞争力而言,国频设计水平仍处于低端. 与大型国际制造商相比,上述射频设备制造商在销售和市场份额上仍存在较大差距. 可以看出,国内厂商仍处于起步阶段,仍有很大的增长空间.
考虑到国际射频产业的市场布局,根据相关机构的统计,在声表面波滤波器中,全球市场份额的80%是村田制作所(滤波器的典型产品: SF2433D,SF2038C-1,SF2037C-1,等),TDK(典型滤波器产品: DEA162690LT-5057C1,DEA165150HT-8025C2,DEA252593BT-2074A3),太阳诱电(射频设备: D5DA737M5K2H2-Z,AH212M245001-T等)等,用于4G的BAW滤波器/ 5G是Broadcom,而Qorvo则占据了95%的市场空间,PA芯片则占据了90%以上的全球市场,集中在Skyworks,Qorvo和Broadcom的手中.
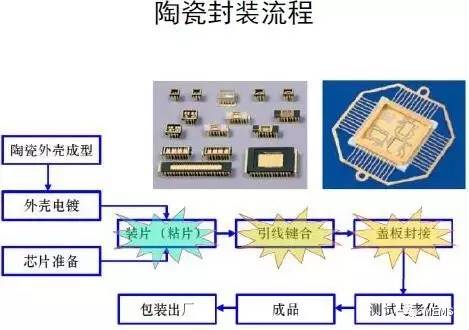
除了占领大部分市场之外,上述RF制造商还基本完成了整个RF前端产品线的布局,拥有专用的制造和包装链,并使用IDM模型整合了庞大的设计能力,产品性能和容量控制方面的优势. 同时,获得专利的技术储备还使RF巨头有了更宽广的护城河,这使得后来者很难在短期内超越.
射频设备的挑战与创新
在从4G到5G的演进过程中,RF设备的复杂性逐渐增加,产品将在设计,工艺和材料上经历不断的变化. 同时,射频前端仍然面临许多技术问题,例如功耗,尺寸,天线数量,芯片设计,温度漂移,信号干扰以及不同类型信号的和谐共存. 如何解决这些问题已成为业界关注的焦点,也是射频器件的创新.
随着半导体材料的发展,诸如Si射频器件 陶瓷 封装,GaAs,GaN之类的RF材料以及诸如陶瓷和玻璃之类的封装基板材料的变化带来了功耗,效率,发热问题,尺寸等方面的改善. 将自然导致射频设备的发展. 这是一项重要的创新. 但是,除了材料创新之外,RF设备还有哪些其他创新方式?
制造过程
当前,射频器件涉及的主要工艺是GaAs,SOI,CMOS,SiGe等.
GaAs: GaAs具有良好的电子迁移率,适用于距离长射频器件 陶瓷 封装,通信时间长的高频电路. GaAs器件的电子迁移率比Si高得多,因此它们使用特殊的工艺. 在早期,它们是MESFET金属半导体场效应晶体管,后来演变为HEMT(高速电子迁移率晶体管),pHEMT(界面应变型高电子迁移率晶体管),目前是HBT(异质结双载流子晶体管).
GaAs的生产方法与传统的硅晶片生产方法有很大不同. GaAs需要使用外延技术制造. 该外延晶片的直径通常为4-6英寸,小于12英寸的硅晶片. 许多. 外延晶片需要,砷化镓的原材料成本比硅要高得多,最终导致GaAs成品IC的成本相对较高;
SOI: SOI流程的优势在于它可以集成逻辑和控制功能,而无需其他控制芯片;

CMOS: CMOS工艺的优势在于可以将RF,基频和存储组件结合在一起的高度集成度,同时降低组件成本;
SiGe: 近年来,SiGe已成为最有价值的无线通信IC工艺技术之一. 就材料特性而言,SiGe具有良好的高频特性,良好的材料安全性,良好的导热性,成熟的工艺,较高的集成度和较低的成本优势. SiGe不仅具有硅工艺集成,产量和成本方面的优势,还具有3至5类半导体(如砷化镓(GaAs)和磷化铟(InP))的速度优势,只需堆叠即可添加金属和电介质为了减少寄生电容和电感,SiGe半导体技术可用于集成高质量的无源组件.
SiGe工艺可以与硅半导体VLSI中的几乎所有新工艺技术兼容,这是未来的趋势. 但是,SiGe需要继续在击穿电压,截止频率,功率等方面做出努力,以取代砷化镓的状态.
RF PA使用的工艺是GaAs,SOI,CMOS和SiGe;射频开关使用SOI和GaAs工艺; LTE LNA主要使用SOI,CMOS.
进入5G时代,Sub-6GHz和毫米波级中各种RF组件的材料和技术可能会发生变化. SOI可能会成为一项重要的技术,具有制造各种组件的潜力,同时它将促进集成.
解决天线问题
以手机为例. 由于5G技术的特殊要求,从智能电话系统架构的角度来看,5G需要更高的数据速率和更多的天线. 这些天线包括多频带载波聚合,4x4 MIMO和Wi-Fi MIMO. 这给天线调谐,放大器线性度和功耗以及其他系统干扰带来了挑战. 同时,天线数量的增加留下了越来越少的天线空间. 因此,RF制造商可以与GPS,WiFi,IF,HF和UHF RF通道共享相同的RF天线,从而可以减少天线数量并节省空间.
对于天线问题,除了上述无线多路复用器方法外,还可以使用天线调谐,并且可以将每个天线调谐到工作频段以提高效率.
集成
未来,诸如滤波器之类的RF设备将显示出朝着小型化,改进的设备形式和组合方向发展的趋势.
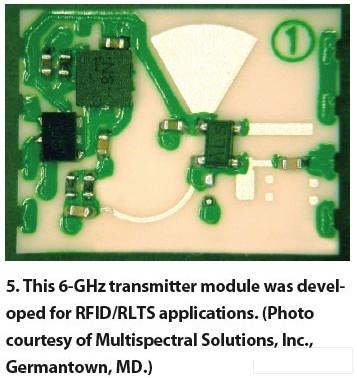
与十年前的4G一样,LTE连接建立在现有3G技术的基础上;早期的5G功能是通过在现有LTE设计中添加单独的芯片组来实现的,这意味着5G组件基本上是智能手机的设计,而不是集成到核心芯片组中,但是它具有对芯片尺寸,性能和功耗有一定影响.
单模5G调制解调器,5G RF和单频段5G RF前端,它们独立于现有LTE RF链路. 这种第一代5G调制解调器设计还需要其他支持组件.
因此,随着行业的成熟,改善射频设备的集成度是必然的发展方向,行业将期待进一步优化核心电路设计. 有望实现一种高度集成且紧凑的RF体系结构,该体系结构可在一台设备中同时支持6 GHz以下和毫米波频段5G.
封装方法
在5G时代,RF制造商越来越关注RF前端解决方案中的封装创新,例如更紧密的组件布局,双面安装,保形/区域屏蔽,高精度/高速SMT等.
5G频段分为毫米波和6G以下. 频段越高,对小型包装的要求越高. 这种新的包装形式逐渐实现了设备包装的小型化,批量生产,低成本和高精度. ,集成.
为了集成用于5G移动通信的天线元件和RF组件,市场上已经提出了各种具有不同架构的封装解决方案. 基于成本和成熟的供应链,扇出WLP / PLP封装受益于更高的信号性能,更低的损耗和更小的外形尺寸. 这是一个很有前途的AiP集成解决方案,但它需要双面重型布线层(RDL). 除少数制造商外,大多数OSAT都不准备使用该技术进行批量生产.
在系统级封装(SiP)部分中,它分为各种RF设备的第一级封装,例如芯片/晶圆级滤波器,开关和放大器,以及在表面安装时的第二级SiP封装( SMT)阶段. 其中,各种器件与无源器件一起组装在SiP衬底上.
SiP提供所需的小尺寸,更短的信号路径和更低的损耗. 同时,由于功能不断增加,对集成的要求越来越高,因此市场对SiP封装方法也提出了更多要求.
可以看出,近年来对RF器件封装的理想解决方案进行了许多研究,他们致力于在成本,体积和性能要求之间寻求平衡. 将来,它将成为射频设备的创新方式之一.
结论追赶和替换RF设备要求国内制造商有决心和毅力来“坐在冷凳上”. 它还要求政府和投资机构给予企业更多的耐心. 在5G和物联网的大趋势下,把握射频设备在新设计,新工艺,新材料,新包装等方面的突破点,将市场机会作为赶上持续创新的机会.
本文来自电脑杂谈,转载请注明本文网址:
http://www.pc-fly.com/a/tongxinshuyu/article-263901-1.html
-

-
 孙景伟
孙景伟 -
 游茹月
游茹月期待krystal



 联通微信客户服务缩短了与客户的距离
联通微信客户服务缩短了与客户的距离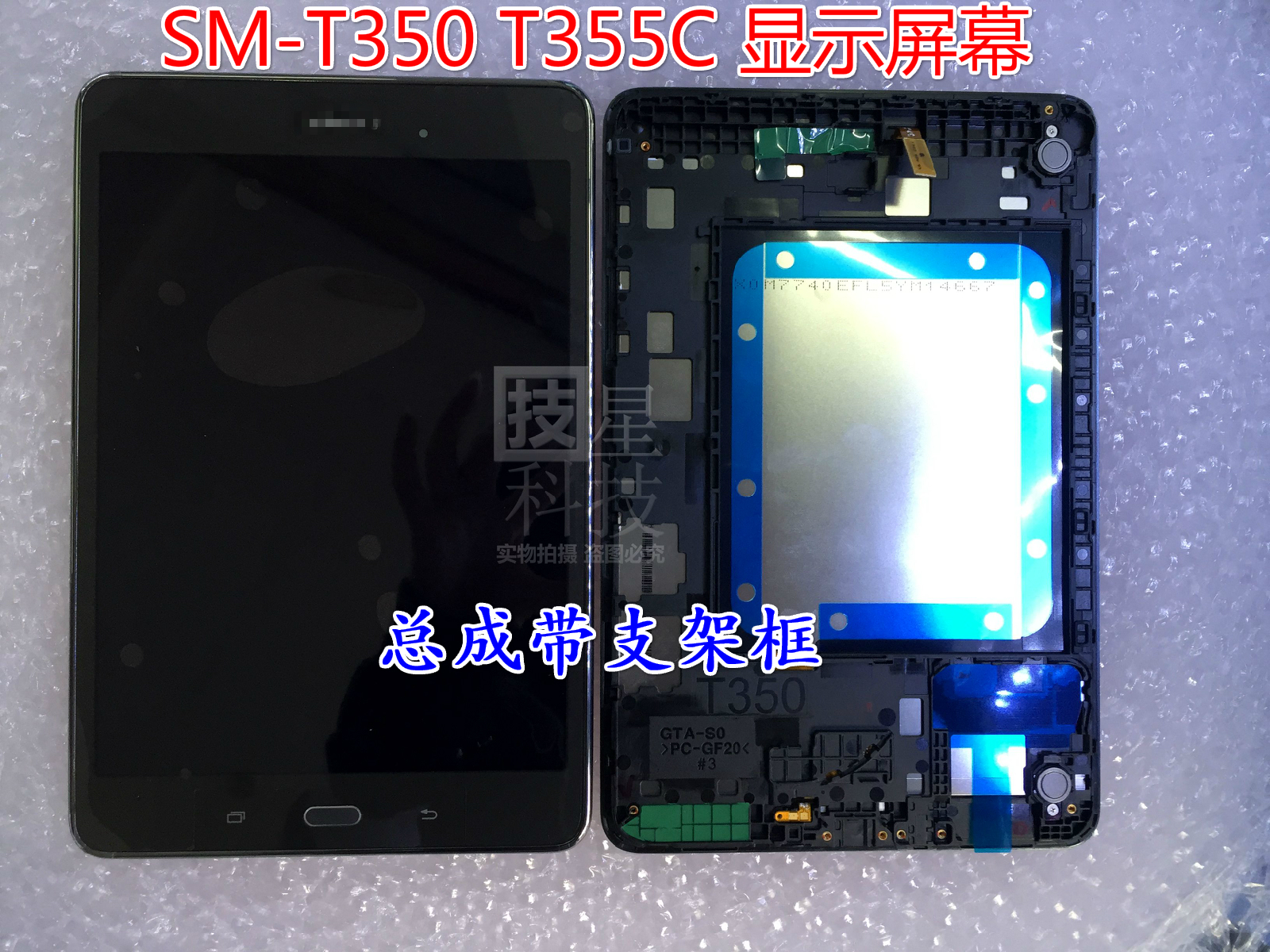 三星t220显示器白屏无法画面,厂家赔钱修换屏幕
三星t220显示器白屏无法画面,厂家赔钱修换屏幕 iPhone6看起来是真是假?
iPhone6看起来是真是假? 华硕笔记本触控板打开和关闭的三种方法
华硕笔记本触控板打开和关闭的三种方法
大家都很现实