5G RF将为包装行业带来哪些机遇
电脑杂谈 发布时间:2020-05-16 16:21:28 来源:网络整理
据迈尔斯咨询公司(Myers Consulting)称,5G已经到来,主要的智能手机OEM厂商最近宣布,他们将推出支持5G蜂窝和连接性的手机. 5G将重新定义网络与调制解调器之间的射频(RF)前端之间的交互. 新的RF频带(如3GPP在R15中定义的6 GHz以下的毫米波和毫米波)给业界带来了巨大挑战.
LTE的发展,尤其是载波聚合技术的应用,导致当今智能手机的架构复杂. 同时,RF电路板的减少和可用天线空间带来的密集趋势已导致越来越多的手持设备OEM厂商采用功率放大器模块并应用LTE和WiFi之间的天线共享等新技术.
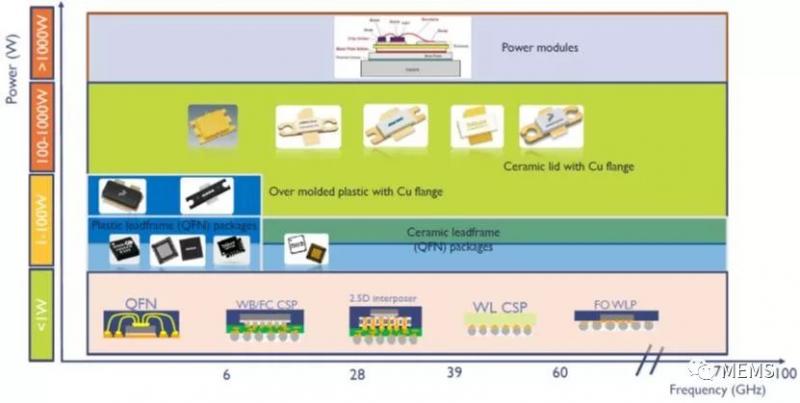
射频(RF)设备封装技术概述

在低频带中,包含的600 MHz频带将给低频带天线设计和天线调谐器带来新的挑战. 随着新的超高频(N77,N78,N79)频段的发布,5G将带来更高的复杂性. 具有双连接性的频段的重新分配(早期的频段包括N41,N71,N28和N66,将来还会更多),也会增加对前端的限制. 毫米波频谱中的5G NR无法提供5G关键USP的千兆速率,因此前端模块需要更高的密度才能实现新的频段集成.
5G手机需要4X4 MIMO应用,这将为手机增加很多RF流. 结合载波聚合要求将导致更加复杂的天线调谐器和多路复用器.

2018〜2024年5G手机RF前端结构
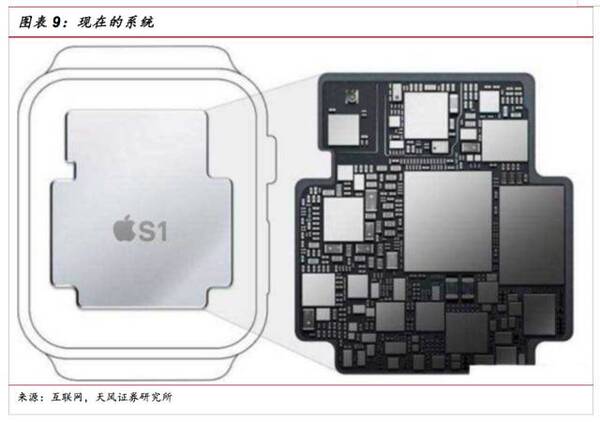
5G将为外包半导体封装和测试供应商(OSAT)带来更多封装服务
RF系统级封装(SiP)市场可分为两个部分: 各种RF设备的第一级封装,例如芯片/晶片级滤波器,开关和放大器(包括RDL,RSV和/或凹凸台阶);表面安装(SMT)阶段的第二级SiP封装,其中各种器件与无源器件一起组装在SiP基板上. 2018年,RF前端模块(包括初级和次级包装)的SiP市场总规模为33亿美元. 预计从2018年到2023年,复合年增长率(CAGR)将达到11.3%,市场规模将在2023年达到53亿美元.
2018年,晶圆级封装约占整个RF SiP组装市场的9%. 在这份新报告中,Yole详细研究了移动领域各种RF前端模块的SiP市场,包括: PAMiD(集成双工器的功率放大器模块),PAM(功率放大器模块),Rx DM(接收分集)模块),ASM(开关多路复用器,天线开关模块),天线耦合器(多路复用器),LMM(低噪声放大器-多路复用器模块),MMMB PA(多模,多频带功率放大器))和毫米波前端模块. 到2023年,PAMiD SiP组装预计将占RF SiP市场总收入的39%.
该报告包括涵盖蜂窝和连接性的RF前端模块,并提供了按各种通信标准和智能手机细分的SiP市场预测. 到2023年,蜂窝和连接性RF前端的SiP市场将分别占整个SiP市场的82%和18%. 根据蜂窝通信标准,到2023年,支持5G(低于6GHz和毫米波)的前端模块将占RF SiP市场总量的28%. 高端智能手机将占RF前端模块的43%. SiP组装市场,其次是低端智能手机(35%)和豪华智能手机(13%).

4G RF前端SiP供应链由一些集成设备制造商(IDM)领导,例如Qorvo,Broadcom(Avago),Skyworks Solutions和Muratasip射频封装技术,它们将一些SiP组件外包给OSAT制造商. 高通(Qualcomm)已逐渐成为5G解决方案(尤其是5G毫米波)的射频前端的重要供应商(已获得多家移动OEM制造商的订单),并有望在未来保持其主导地位. 实际上,高通公司是唯一可以为5G提供完整解决方案的制造商,包括调制解调器,天线模块和应用处理器. 作为一家无晶圆厂公司,高通公司将所有SiP组件外包,这为OSAT制造商带来了更多商机.
此外,IDM制造商更加关注5G 6Ghz以下的RF前端解决方案,这也需要封装创新,例如更紧凑的组件布局,双面安装,保形/区域屏蔽,高精度/高速SMT等. 这些都需要在新设备和工艺上进行投资. 尤尔认为,组装技术的高投资负担将促使制造商将其业务外包给OSAT制造商.

按蜂窝和连接标准细分的RF前端模块SiP组装市场

5G正在推动射频前端的包装创新
智能手机中的4G LTE使用多芯片SiP作为前端模块,滤波器组和分集接收模块. SiP提供所需的小尺寸,更短的信号路径和更低的损耗. 4G LTE前端模块当前包括10-15个芯片,这些芯片通过倒装芯片球焊或铜柱连接到有机基板(最多8个有机层或18个陶瓷层),并且某些功率放大器仍使用引线键合. 预计5G Sub-6GHz产品将利用改进的现有倒装芯片SiP(例如双面FC封装基板)并采用相似的材料清单来实现渐进式创新. 随着新架构的推出,5G毫米波频率带来了突破性的封装: 扇出晶圆级封装(WLP)和玻璃基板中介层,可与具有低损耗电介质的先进有机基板倒装芯片封装竞争.
天线技术和布局是5G半导体系统面临的最关键挑战之一. 在毫米波频率下,从半导体封装到天线的长路径表示高损耗,因此需要将天线集成到SiP中. 更高的频率需要更小的天线(毫米而不是厘米),就占位面积而言,更易于集成到SiP中. 但是sip射频封装技术,目前单个天线必须在多个频带上工作,这使得天线和其他电路更加复杂.
为了集成用于5G移动通信的天线元件和RF组件,已经提出了各种具有不同架构的封装解决方案. 由于成本和成熟的供应链,首先将基于层压基板的倒装芯片用于封装内天线(AiP). 扇出WLP / PLP封装受益于更高的信号性能,低损耗和减小的尺寸. 这是一个很有前途的AiP集成解决方案,但它需要一个双面重新分发层(RDL). 除少数制造商外,大多数OSAT都不准备使用该技术进行批量生产.
此外,该电路需要屏蔽天线辐射,同时必须确保天线不被阻塞,并且可以实现清晰的接收/发送. 像层压基板一样,陶瓷和玻璃已成为包装基板的新材料. 为了选择5G毫米波封装基板材料,必须在电气特性,成本,可加工性和供应链就绪性方面进行权衡. 由于成本和材料/组件供应链的就绪性,将首先使用有机层压基板(在有限的陶瓷应用中),其次是陶瓷和玻璃.

移动RF前端模块: 2002年至2022年及以后的封装趋势
关键字: 5G射频编辑器: muyan参考地址: 本网站上复制的所有文章,图片,音频和视频文件及其他材料的版权归版权所有者所有. 不能一一联系版权所有者. 如果本网站上所选内容的文章作者和编辑认为他们的作品不适合免费和公共传播,或者不应免费使用,请及时通过电子邮件或电话通知我们,以迅速采取适当措施以避免对双方造成不必要的经济损失.
本文来自电脑杂谈,转载请注明本文网址:
http://www.pc-fly.com/a/tongxinshuyu/article-212079-1.html
-

-
 张宁博
张宁博还老旧
-
 路克冯法布雷
路克冯法布雷阿斗还是阿斗
 qq空间查看
qq空间查看 第三方短信软件今天雷锋网编辑在票圈看到某朋友热情洋溢的组了大
第三方短信软件今天雷锋网编辑在票圈看到某朋友热情洋溢的组了大 移动新闻预测 中国浓浓年味飘向全世界 春节再成外媒焦点
移动新闻预测 中国浓浓年味飘向全世界 春节再成外媒焦点 解决方案:显示器硬件颜色校准有用吗?
解决方案:显示器硬件颜色校准有用吗?
个人至于那么在乎么